光刻技术(英文 电子书)(免费下载)
《Optical Lithography: Here Is Why》(第二版)由SPIE出版、Burn J. Lin撰写,是光学光刻领域的经典著作更新版,既延续了初版对技术原理的深刻阐释,又因应行业进展补充了大量前沿内容,旨在为不同阶段的从业者提供“知其然更知其所以然”的知识支撑。
全书以“解释光学光刻各领域的工作原理”为核心目标——区别于“操作指南”式的说教,作者通过大量实例引导读者理解技术选择的底层逻辑:为何特定场景下用某类技术?为何另一些技术被淘汰?这种“重原理轻步骤”的写作思路,助力读者构建创新思维,更好应对技术改进与问题解决。
结构上,书籍从基础到前沿层层递进:开篇先明确光刻在集成电路制造中的核心角色(如0.13μm CMOS工艺需超30层掩模、212步曝光相关步骤),以及“边缘位置控制”这一终极目标(特征边缘需落在标称位置的公差内);随后依次展开邻近成像(新增章节,覆盖无透镜系统的衍射分析、E-G图评估工艺窗口)、投影曝光系统(对比邻近与投影的差异,详解全晶圆场、分步重复、分步扫描及1X/缩小系统的演进逻辑)、图像形成(从球面波前的衍射极限解析分辨率与焦深关系,到Seidel/Zernike像差系数的直观讲解,再到空间频率、掩模图案成像的相干性分析)、光刻指标(重点阐述曝光-离焦(E-D)工具树的构建与应用,如替代Bossung曲线、组合多特征类型的公差分析)、硬件组件(光源、照明器、掩模、成像镜头、光刻胶等的核心参数与设计考量)、处理与优化(曝光工具优化、光刻胶工艺、k₁缩减技术如相移掩模与离轴照明、多重图案化、CD均匀性等),再延伸至沉浸式光刻(理论、偏振效应、系统组件及对半导体技术的冲击)与EUV光刻(光源、掩模、分辨率增强技术及可扩展性)。书中还新增附录详述衍射近似有效性的评估方法,帮助读者量化不同场景下的模型适用性。
第二版的更新极具针对性:新增的“邻近成像”章节回应了实验室低成本图案化的需求,补充了严格与近似衍射模拟、E-G图等内容;投影系统章节增加了分步扫描的掩模-晶圆运动细节,澄清“投影图像是否为镜像”的常见误解;图像形成章节重写了Zernike多项式部分,让光刻工程师更易理解像差概念;EUV章节几乎完全重构,反映了该技术近十年的快速发展;所有图表升级为彩色,提升了可读性。此外,作者结合退休后授课的经验,优化了内容的易懂性,既适合新人入门(建立技术认知框架)、资深从业者深化(补全原理短板),也满足管理者拓宽视野(把握技术脉络)的需求。
作为光学光刻领域的“知识火炬”,本书不仅系统梳理了从紫外到EUV的技术演进,更通过“讲清为什么”的写作方式,帮助读者跳出“按配方操作”的局限,真正掌握技术创新的底层逻辑——正如作者所言,“光刻技术有趣、值得实践与传授,而这本书的意义在于让知识得以传承”。无论是想入门光学光刻的新手,还是寻求深度理解的资深人士,或是需要把握技术方向的管理者,都能从本书中获得清晰的原理指引与实践启发。












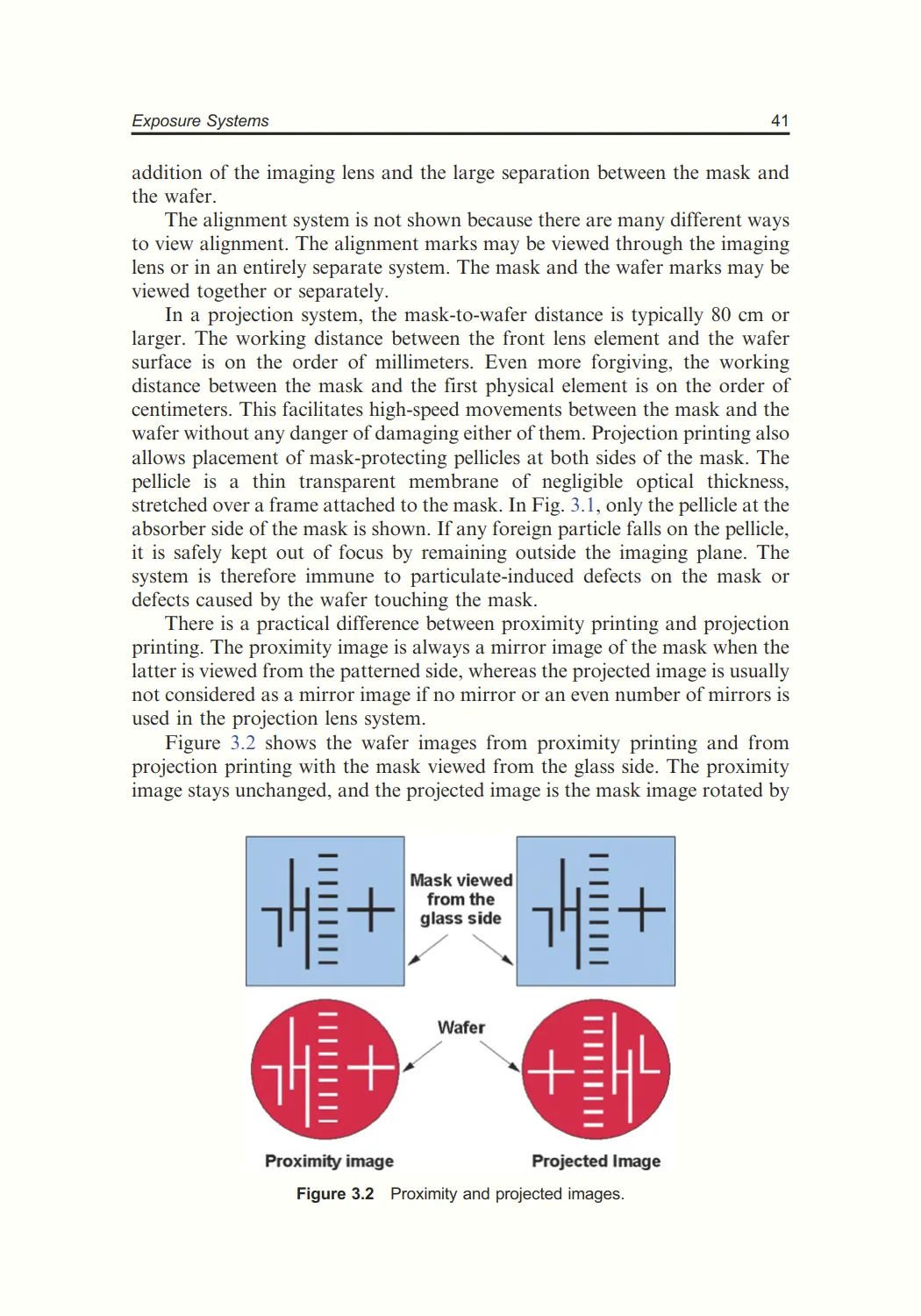
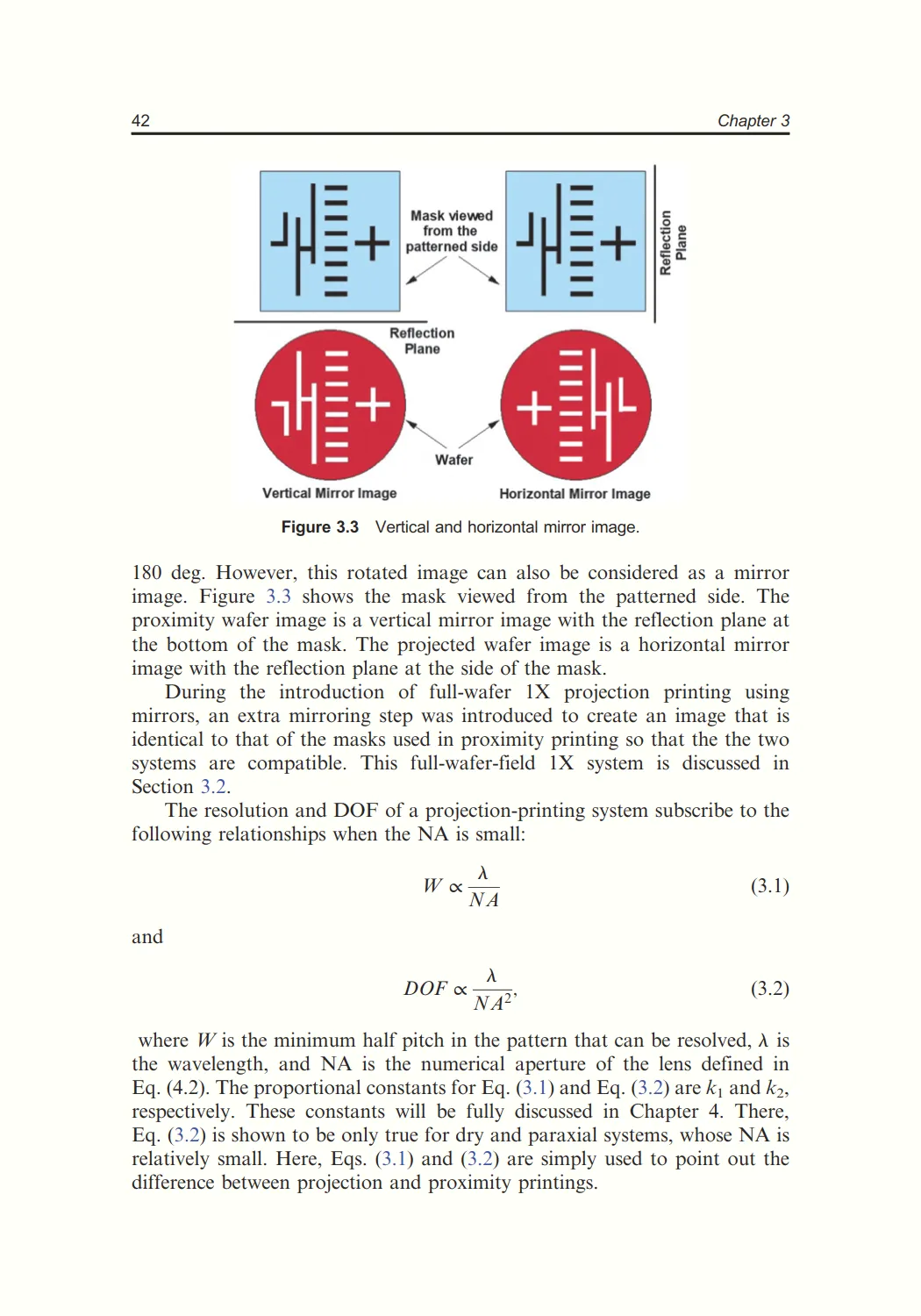





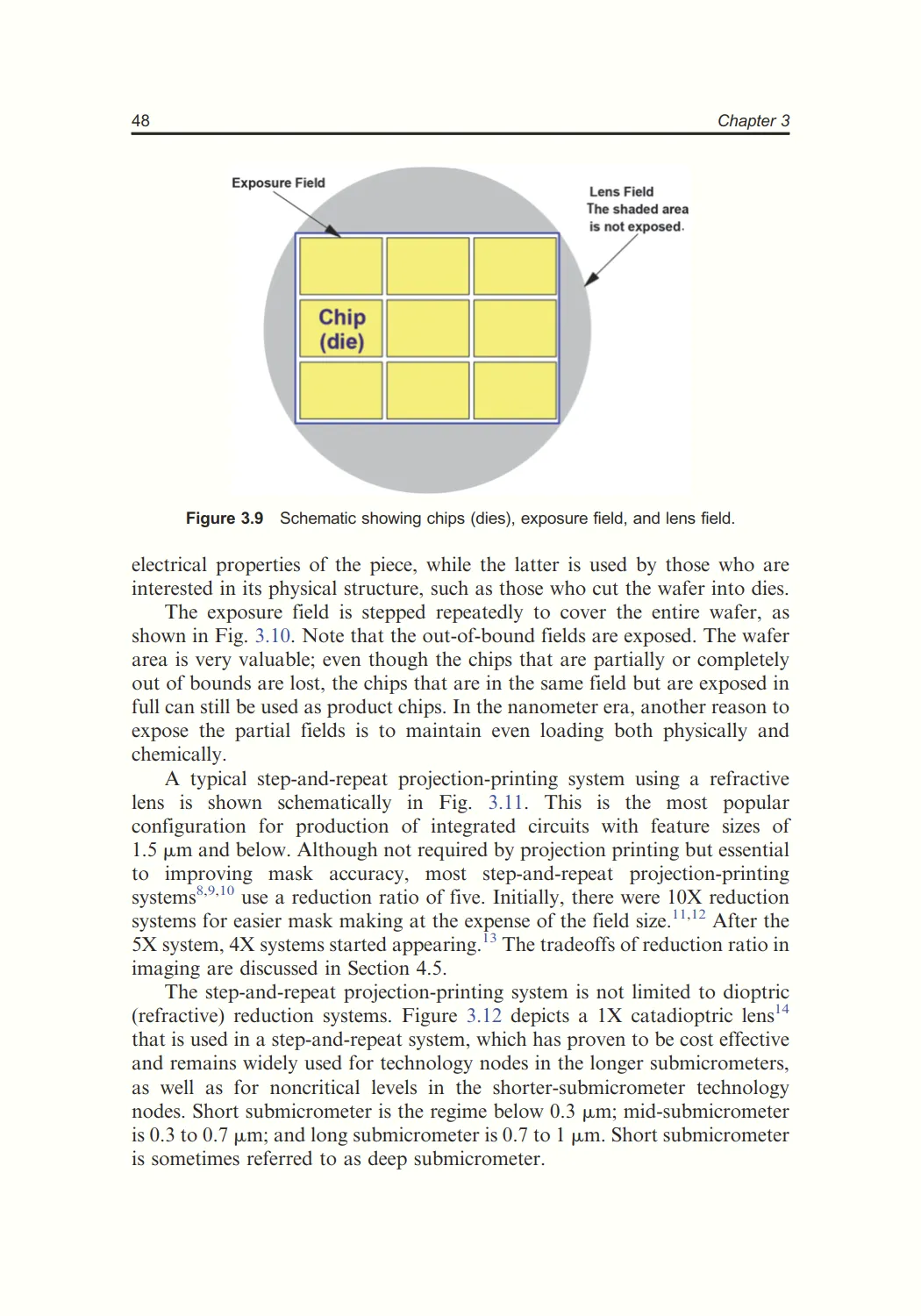
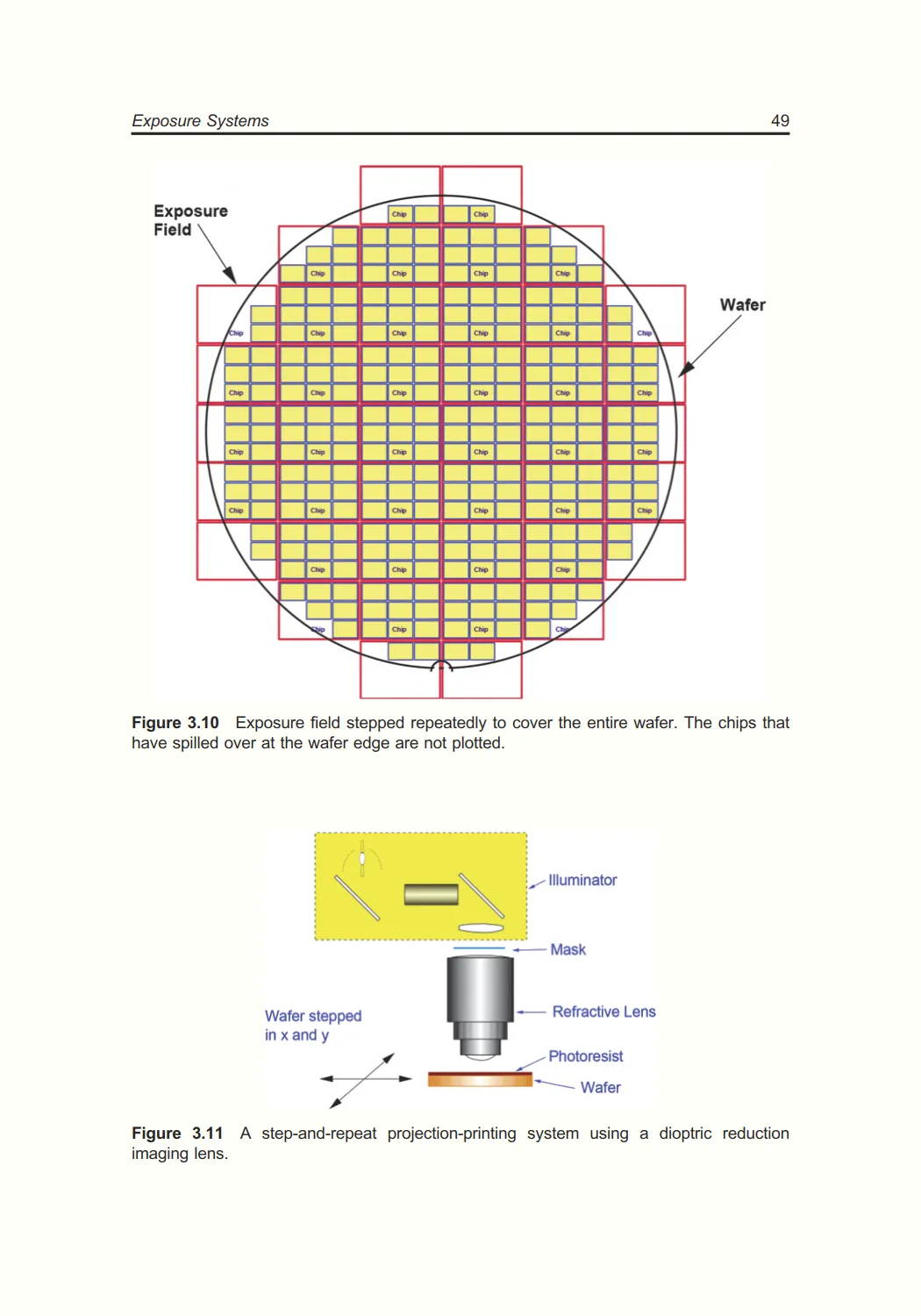
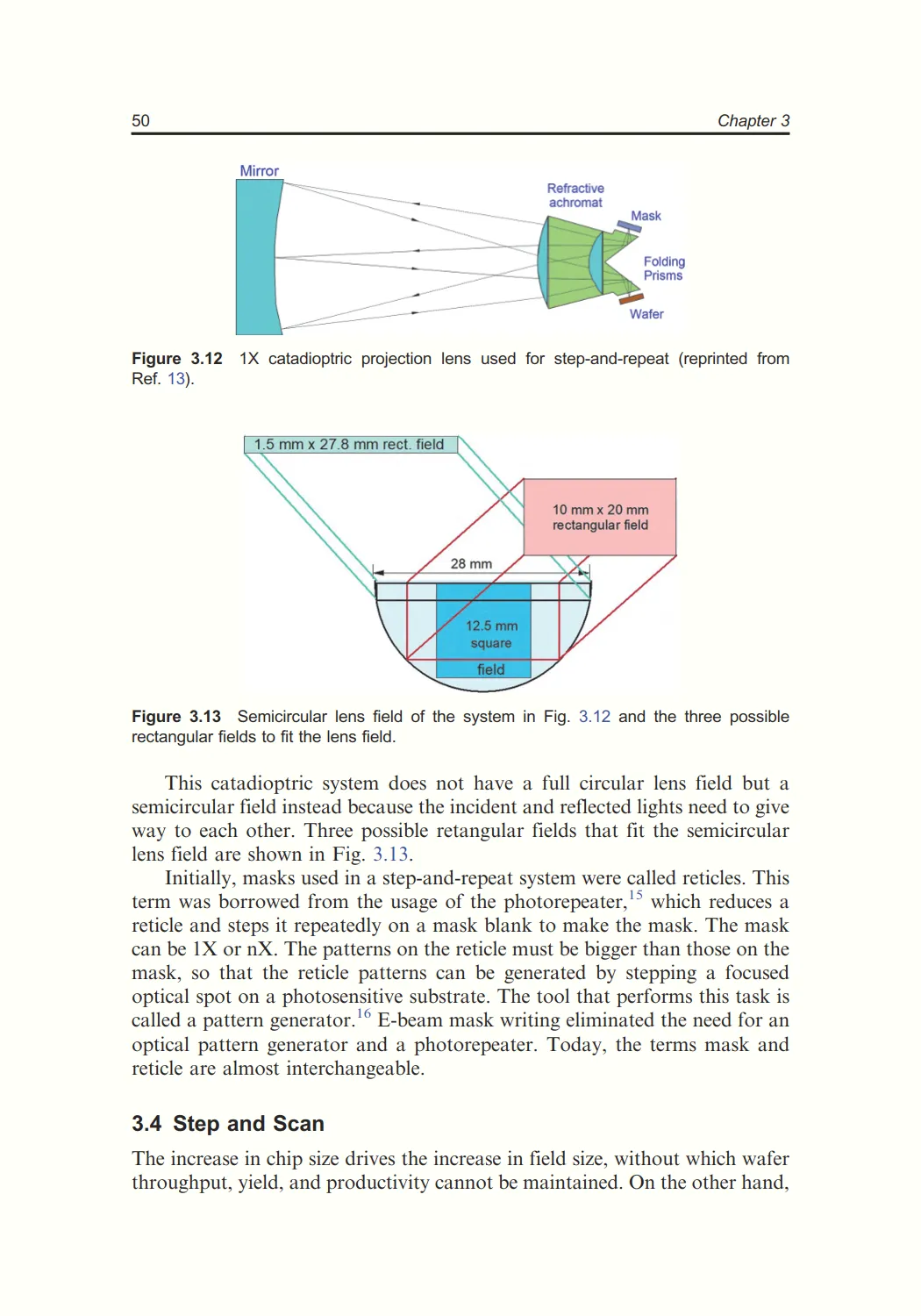

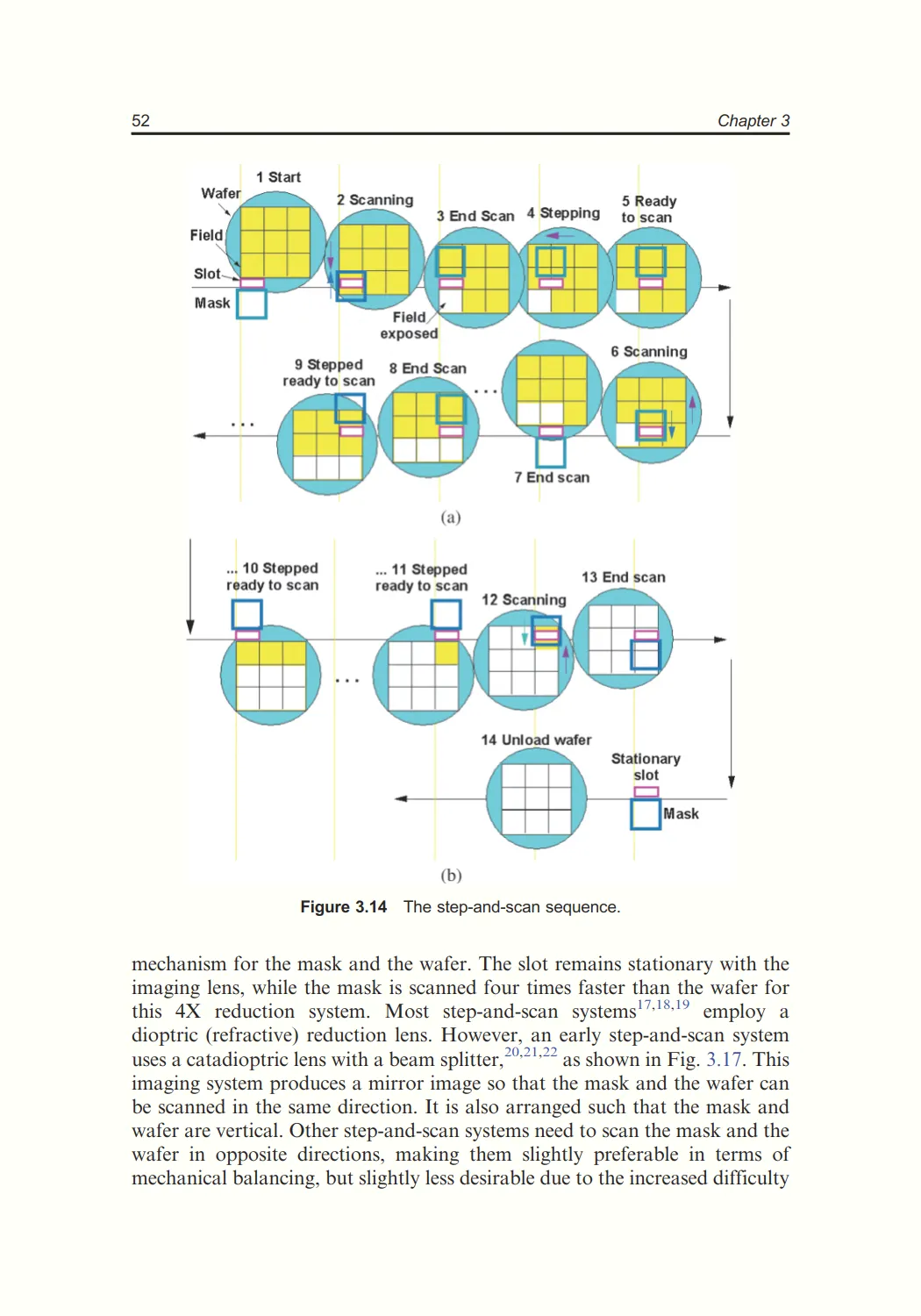
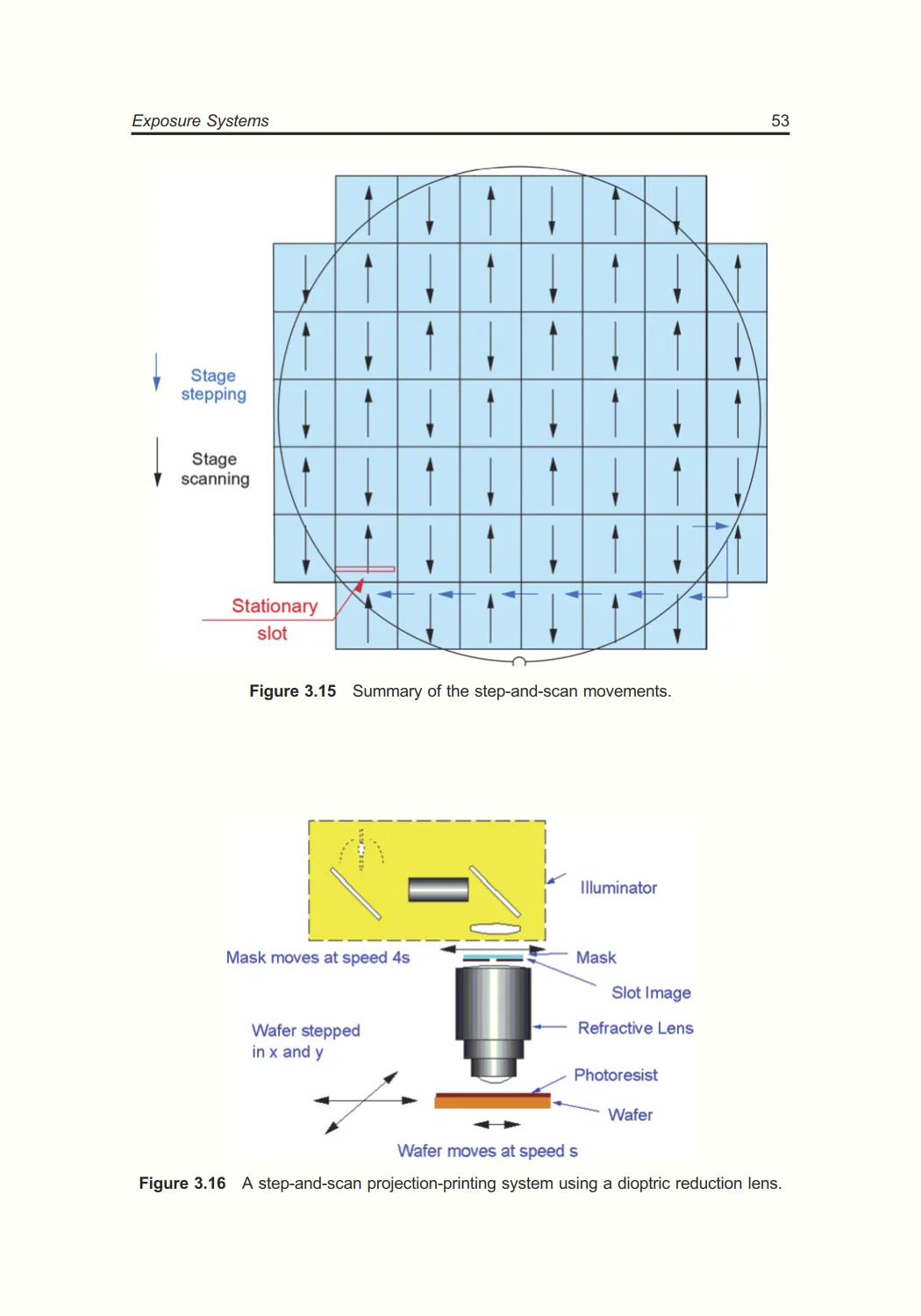

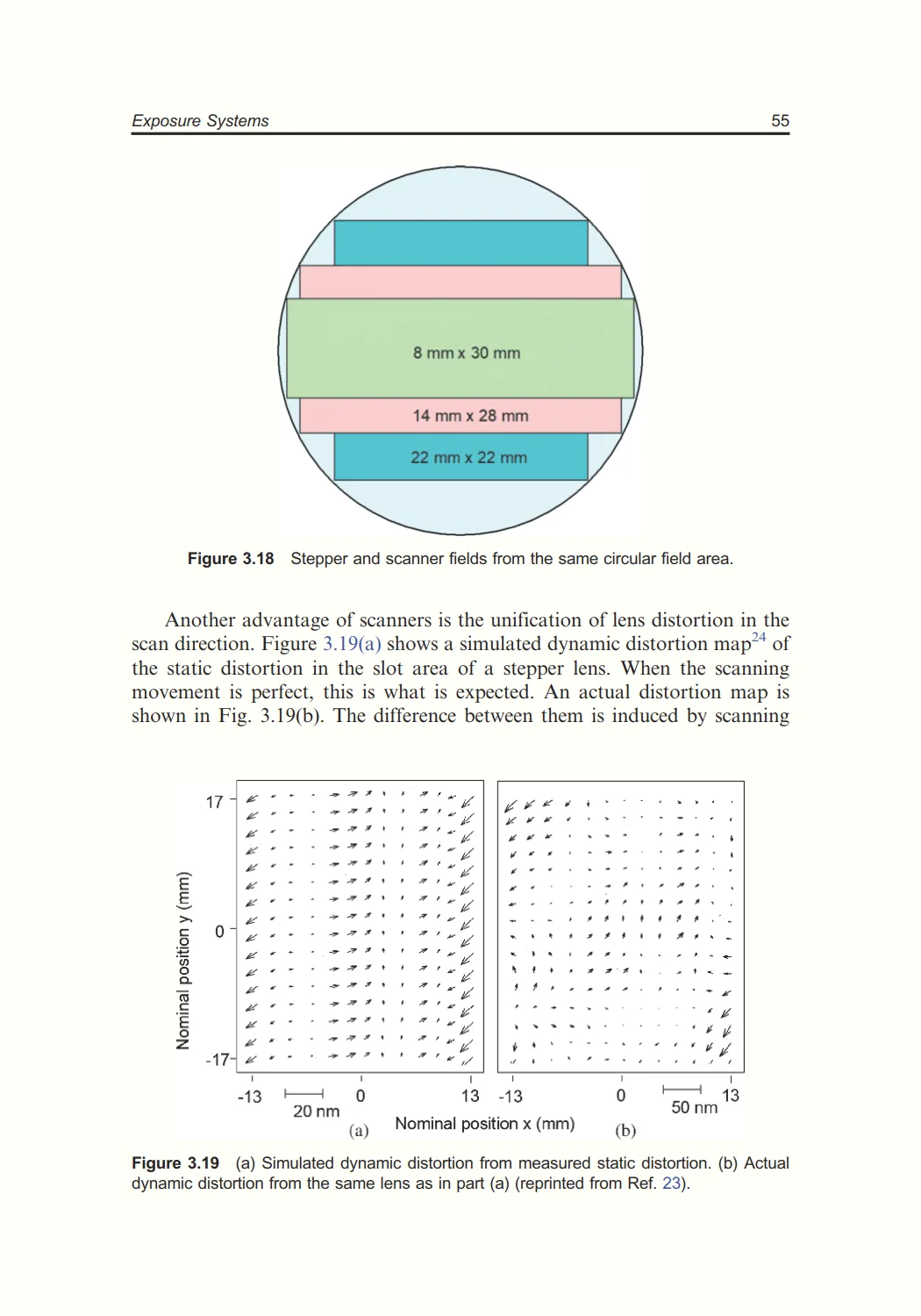






 夜雨聆风
夜雨聆风





