面向AI半导体先进封装需求,京瓷宣布推出多层陶瓷核心基板
4月27日,日本京瓷公司(Kyocera Corporation)宣布,将针对xPU 与ASIC 等先进半导体封装,推出全新商业化的“多层陶瓷核心基板”(multilayer ceramic core substrate)。该项创新产品预计将于2026 年5 月26 日至29 日,在美国佛罗里达州奥兰多举行的国际半导体封装技术研讨会(ECTC 2026)上正式亮相。
京瓷公司表示,近年来生成式人工智能(AI)与大型语言模型(LLM)的爆发性成长,带动了全球AI数据中心的扩建潮,进而推升市场对高性能xPU 与ASIC 半导体的需求。这些高性能计算芯片需要尺寸更大、密度更高的封装基板,特别是在2.5D 封装技术的应用上更为显著。
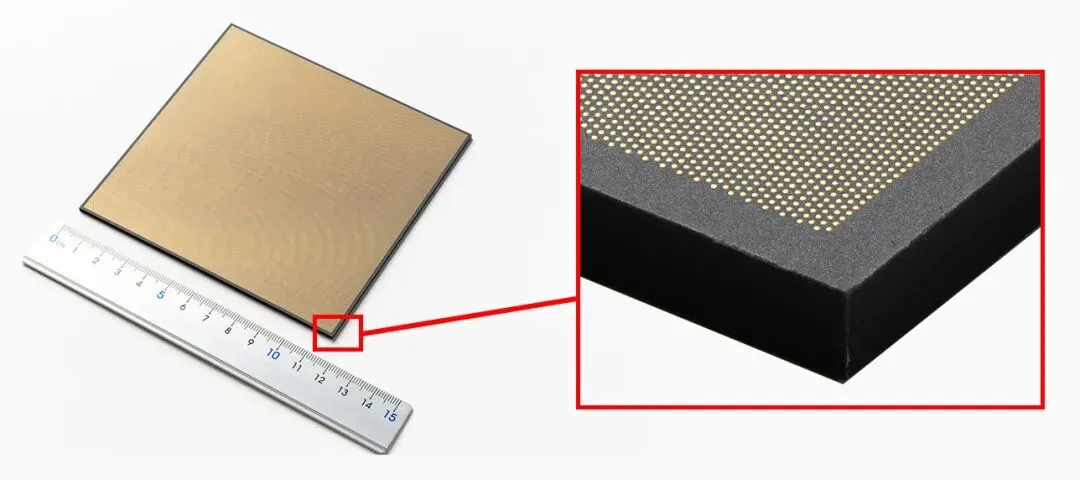
然而,传统使用有机材质制造的核心基板在面对大尺寸需求时,容易遭遇基板翘曲(warpage)及布线微型化困难等性能瓶颈。为突破这些限制,京瓷运用其在积层陶瓷材料领域的专业技术,开发出这款具备更高刚性与更精细布线能力的新型多层陶瓷核心基板。
京瓷公司强调,新型多层陶瓷核心基板采用其独家的精密陶瓷(Fine Ceramic)材料制成,具备以下三大特点:
1、高刚性多层陶瓷芯基板最大限度地减少了翘曲,这是影响大型封装基板的关键挑战
京瓷的多层陶瓷芯基板比有机材料制成的芯基板具有更高的刚性和抗变形(弯曲)能力,从而最大限度地减少了每次安装过程中的翘曲。因此,京瓷的多层陶瓷技术能够使用更薄的基板实现更高的器件性能,同时有助于进一步小型化。
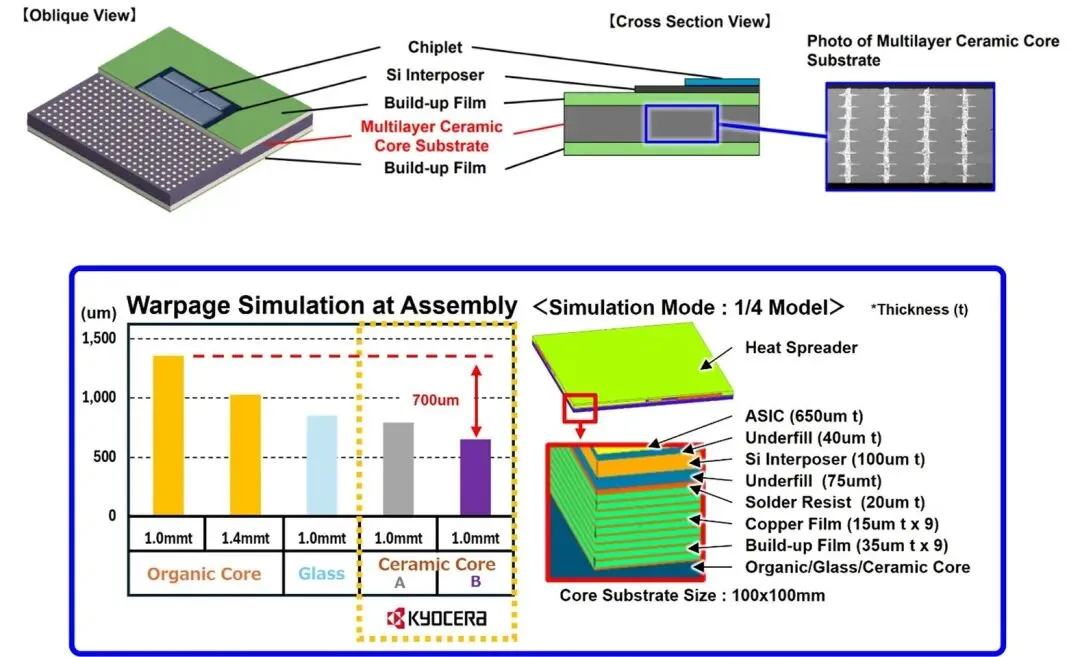
2. 多层陶瓷结构可实现更精细的布线
在多层陶瓷基板中,陶瓷层之间的导电路径称为通孔。这些通孔在陶瓷具有可塑性时(烧结或烧制之前)形成,与传统有机芯基板中用于制造通孔的钻孔工艺相比,陶瓷基板能够通过更精细的微加工工艺实现更精细的布线。陶瓷基板中更小的通孔直径和更小的通孔间距解决了传统有机芯基板中高密度布线所面临的挑战。
3. 支持定制设计需求和设计阶段的性能模拟
在设计阶段,京瓷会根据器件性能目标和指定的封装工艺,提供热学、电学和基板翘曲仿真。这些仿真数据能够确保客户开发效率更高,并确保最终器件达到设计目标。
面对半导体产业日新月异的需求,京瓷公司强调,未来将持续致力于开发新型封装材料与技术,以满足客户不断演进的标准与期望。此次发表的多层陶瓷核心基板,预期将为下一代高性能AI计算芯片提供更稳定、更强大的封装解决方案。
编辑:芯智讯-浪客剑
行业交流、合作请加微信:icsmart01芯智讯官方交流群:221807116
 夜雨聆风
夜雨聆风




