电子元器件:AI 创新带动产业链全栈价值重塑(27页报告)
如需报告请联系客服或扫码获取更多报告

2.1 PCB:进入高多层、高速率、新材料时代
AI 算力与高速互联驱动 PCB 规格跃迁。AI 服务器、800G/1.6T 交换机及高速网络基础设施的规模化部署,对超高密度互连与低损耗传输提出了更高要求,推动 PCB 在架构和材料上同步创新。架构层面,布线密度、信号与电源完整性需求推动 PCB 连接代替铜缆连接及传统多层板向更高层数发展,以英伟达为例,GB300 的 Switch tray 由 5+12+5 HDI 升级为更高层的6+14+6 HDI 以满足更密集的互连。在材料层面 CCL、铜箔、玻纤布正向超低损耗方向升级,以保证信号完整性和系统可靠性。
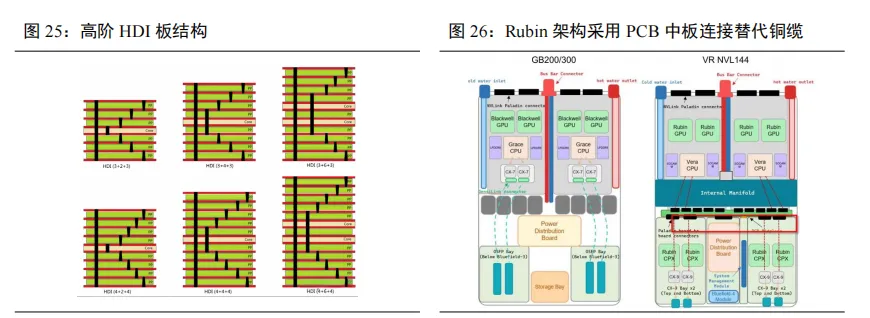
CCL 材料系统性升级。覆铜板(CCL)是 PCB 核心基材,成本占比达 40%,其主要由铜箔、玻纤布及树脂压合形成。其中,树脂决定基础介电性能与耐热性,玻纤布直接影响整体Dk(介电常数)、Df(损耗因子)及 CTE(热膨胀系数),铜箔的表面粗糙度(Rz)则是决定高频导体损耗的关键。当前 AI 服务器与高速通信需求驱动 PCB 向低 Dk、低 Df 方向演进,倒逼 CCL 材料体系向 M6-M9 等级实现系统性跨越。在此趋势下,上游原材料均迎来协同升级,树脂体系向碳氢树脂、PTFE 改良迭代,玻纤布向低介电布、Q 布高端化发展,铜箔则持续降低表面粗糙度以适配高频高速传输要求。

高端铜箔向高频高速与高密度超细线路方向迭代。铜箔是 CCL 中最重要的材料,成本占比达 39%,铜箔的表面粗糙度直接影响高频信号趋肤效应损耗,AI 服务器推动其向 HVLP、可剥铜等高端铜箔升级以适配高频低损耗与高密度细线化需求。HVLP 超低轮廓铜箔凭借Rz≤0.4μm 的优异特性,可显著抑制高频损耗,成为 M9 及以上级别超低损耗 CCL 关键载体。
在 AI 载板领域,传统铜箔难以满足超薄、超细线路的制程要求,载体化可剥铜凭借稳定加工超薄铜层的工艺优势,有效改善细线化制程良率。根据 Global Info Research 统计,预计 2031年全球载体铜箔产值达 18.85 亿美元,2025-2031 CAGR 达 14.5%。

玻纤布向低介电、低热膨胀方向迭代。玻纤布约占 CCL 成本的 26%,核心作用是强化机械强度并调控介电性能,其性能正朝低介电常数(Dk)、低损耗因子(Df)、低热膨胀系数(CTE)方向推进。受低 Dk/Df 需求驱动,玻纤布已从常规 E 玻璃升级至 Low-Dk 一代/二代布,并进一步向石英布(Q 布)演进。低 CTE 玻纤布因热膨胀系数极低,可保障高温焊接及运行中 PCB尺寸稳定,满足 AI 芯片高热环境下的先进封装需求,已成为 IC 基板的必备材料。目前一二代布是高端 CCL 的主流选择,主要用于 M7-M8 级产品,Q 布凭借低 Dk(3.4)、Df(0.0004)及CTE(0.6)成为 M9 级核心材料。目前高端布产能严重不足,日经纺扩产谨慎,根据富邦投顾预测,2026 年 lowDk 布产能约 1000 万平/月,对应一至三代布需求合计 1850 万平/月。

树脂正向低损耗、高耐热方向升级。树脂作为覆铜板的胶黏与绝缘材料,介电常数与损耗因子直接决定信号传输质量,传统的环氧树脂约占 CCL 成本的 18%,但其高 Dk/Df 已经难以满足高频高速传输需求,高规格覆铜板材料中,主流树脂逐渐转向具备低介电常数、高热稳定性与低吸水率的聚四氟乙烯(PTFE)、碳氢树脂(PCH)及聚苯醚(PPO)。M8 级 CCL 目前以 PPO 为主流基材,通过互穿聚合物网络技术引入环氧树脂改性,以平衡其热塑性带来的耐热性短板。对于 M9 级产品来说,PPO 单层电性能不足,则需进一步引入 Dk/Df 值更低的 PCH或 PTFE 作为补充。尽管 PTFE 在介电性能上最为优异,但受限于良率及加工成本,当前量产方案仍以 PPO 混合碳氢为主。

2.2 被动器件:高端需求与国产替代推动行业景气上行
头部厂商带动被动元器件市场进入涨价潮。受上游银、锡、铜等贵金属及晶圆代工、封测环节涨价影响,被动元器件市场迎来新一轮价格上涨周期,并呈现覆盖广、传导快、龙头引领的特征。涨价种类涵盖包含钽电容、MLCC、芯片电阻、电感等核心品类。其中,龙头国巨旗下 KEMET 一年内两次上调应用于 AI 服务器与汽车电子的钽电容价格,旗下普思亦对电阻系列产品实施调价。国内头部厂商同步跟进,风华高科对电感磁珠、MLCC、电阻等多品类调涨,顺络电子宣布上调部分电感、磁珠价格。头部厂商的调价行为快速带动全行业进入自上而下、全品类覆盖涨价周期。

新兴场景下高端 MLCC 单机量大幅提升。被动元器件中,2024 年电容市场份额达 65%,其中 MLCC 用量最大,应用范围最广。受 AI 服务器及边缘 AI 的发展,高端 MLCC 需求量迎来爆发,根据科创板日报引用,全球被动元件龙头村田表示,AI 将大量消耗 MLCC,英伟达GB300 需搭载 MLCC 约 3 万颗,单 AI 机柜消耗 44 万颗,预计 2030 年 AI 服务器用 MLCC 需求将较 2025 年大增 3.3 倍。新能源车领域受三电系统、智能座舱、自动驾驶传感器等部件带动,XEV 单车被动元器件用量从传统燃油车 3000 颗提升 1.8 万至 3 万颗。根据智研咨询预测,预计 2028 年全球 MLCC 需求量将增长至 5.95 万亿只,市场规模达 1408 亿元。
 夜雨聆风
夜雨聆风




